低介电常数材料
目录
低介电常数材料
在半导体制造中,低 κ 是相对于二氧化硅具有较小相对介电常数 (κ, kappa) 的材料。 低介电数据材料实现是用于允许微电子设备持续缩放的几种策略之一,通俗地称为扩展摩尔定律。 在数字电路中,绝缘电介质将导电部件(互连线和晶体管)彼此分开。 随着组件尺寸的缩小和晶体管之间的距离越来越近,绝缘电介质已经变薄到电荷积聚和串扰对设备性能产生不利影响的程度。 用相同厚度的低 κ 电介质代替二氧化硅可减少寄生电容,从而实现更快的开关速度(在同步电路的情况下)和更低的热耗散。 在谈话中,此类材料可能被称为低 k(口语低 kay)而不是低 k(低 kappa)。
低κ材料
在集成电路和CMOS器件中,二氧化硅可以很容易地通过热氧化形成在Si的表面上,并且可以进一步使用化学气相沉积或各种其他薄膜制造方法沉积在导体的表面上。 由于可以使用多种方法廉价地形成二氧化硅层,这种材料通常用作与其他低介电常数电介质进行比较的基线。 硅芯片中仍在使用的绝缘材料SiO2的相对介电常数为3.9。 该数字是 SiO2 的介电常数除以真空介电常数的比率,εSiO2/ε0,其中 ε0 = 8.854×10−6 pF/μm。 有许多材料具有较低的相对介电常数,但很少有材料可以适当地集成到制造过程中。 开发工作主要集中在以下类别的材料上:
掺氟二氧化硅
通过用氟掺杂SiO2生产氟化石英玻璃,相对介电常数从3.9降低到3.5。 掺氟氧化物材料用于 180 nm 和 130 nm 技术节点。
有机硅酸盐玻璃或 OSG(碳掺杂氧化物或 CDO)
通过用碳掺杂SiO2,可以将相对介电常数降低到3.0,密度降低到1.4 g/cm3,热导率降低到0.39 W/(m*K)。 自 90 纳米技术节点以来,半导体行业一直在使用有机硅酸盐玻璃电介质。
多孔二氧化硅
可以采用各种方法在二氧化硅电介质中产生空隙或孔隙。 空隙可以具有接近1的相对介电常数,因此可以通过增加膜的孔隙率来降低多孔材料的介电常数。 据报道,相对介电常数低于 2.0。 与多孔二氧化硅实施相关的集成困难包括低机械强度和难以与蚀刻和抛光工艺集成。
多孔有机硅酸盐玻璃(掺碳氧化物)
多孔有机硅酸盐材料通常通过两步法获得,其中xxx步包括将不稳定的有机相(称为致孔剂)与有机硅酸盐相共沉积,从而形成有机-无机杂化材料。 在第二步中,有机相通过紫外线固化或在高达 400°C 的温度下退火来分解,在有机硅酸盐低 κ 材料中留下孔隙。 多孔有机硅酸盐玻璃自 45 nm 技术节点以来就已被采用。
旋涂有机聚合物电介质
聚合物电介质通常通过旋涂方法沉积,该方法传统上用于光刻胶材料的沉积,而不是化学气相沉积。 集成困难包括机械强度低、热膨胀系数 (CTE) 失配和热稳定性。 一些旋涂有机低 κ 聚合物的例子有聚酰亚胺、聚降冰片烯、苯并环丁烯和 PTFE。
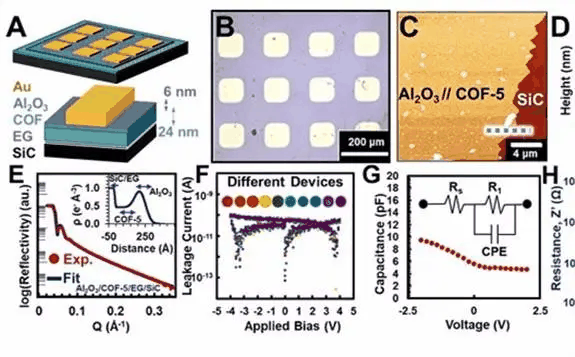
旋涂硅基聚合物电介质
硅基高分子介电材料有氢倍半硅氧烷和甲基倍半硅氧烷两种。
气隙
最终的低 κ 材料是相对介电常数值为 ~1.0 的空气。 然而,导线之间气隙的布置损害了集成电路的机械稳定性,使得构建完全由空气作为绝缘材料组成的IC是不切实际的。 尽管如此,气隙的战略布局可以提高芯片的电气性能,而不会严重影响其耐用性。 例如,英特尔在其 14 纳米 FinFET 技术中将气隙用于两个互连级别。